在目前先進製程工藝進度緩慢的情況下,多晶片整合封裝成了半導體行業的大趨勢,各大廠家不斷玩出新花樣。
 ISSCC 2023 國際固態電路大會上,AMD 提出了多種新的整合封裝的新想法,其中之一就是在 CPU 處理器內部,直接堆疊 DRAM,而且是多層堆疊。
ISSCC 2023 國際固態電路大會上,AMD 提出了多種新的整合封裝的新想法,其中之一就是在 CPU 處理器內部,直接堆疊 DRAM,而且是多層堆疊。
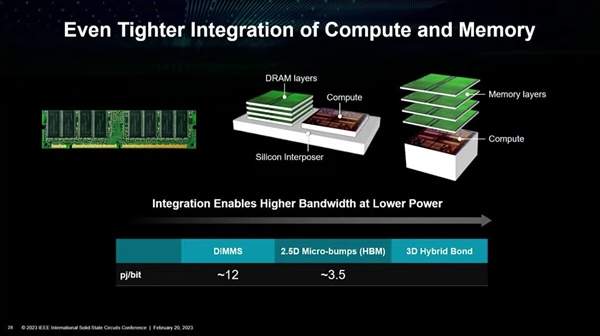 據了解其有兩種辦法,一種方式是讓 CPU 計算模塊、DRAM 並排封裝在矽中介層上,而另一種方式就是在計算模組上方直接堆疊 DRAM,有點像手機 SoC。
據了解其有兩種辦法,一種方式是讓 CPU 計算模塊、DRAM 並排封裝在矽中介層上,而另一種方式就是在計算模組上方直接堆疊 DRAM,有點像手機 SoC。
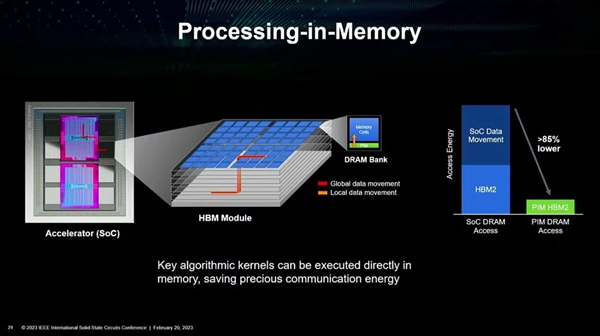 AMD 表示,這種新的設計可以讓計算核心以更短的距離、更高的帶寬、更低的延遲訪問 RAM,而且能大大降低功耗,2.5D封裝可以做到獨立 RAM 功耗的 30%左右,3D混合鍵合封裝更是僅有傳統的1/6。而這樣的好處就是,主板上的 DIMM 插槽可以省掉了,當然這要在 RAM 容量足夠大的情況下。
AMD 表示,這種新的設計可以讓計算核心以更短的距離、更高的帶寬、更低的延遲訪問 RAM,而且能大大降低功耗,2.5D封裝可以做到獨立 RAM 功耗的 30%左右,3D混合鍵合封裝更是僅有傳統的1/6。而這樣的好處就是,主板上的 DIMM 插槽可以省掉了,當然這要在 RAM 容量足夠大的情況下。
不僅如此,AMD 甚至考慮在 Instinct 系列加速卡已經整合封裝 HBM 高頻寬 RAM 的基礎上,在後者之上繼續堆疊 DRAM,但只是一層,容量不會太大。
這樣的最大好處是一些關鍵算法內核可以直接在整合 RAM 內執行,而不必在 CPU 和獨立 RAM 之間往復通信傳輸,從而提升性能、降低功耗。
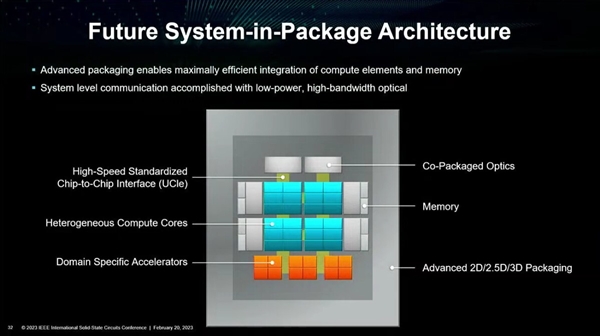 另外,AMD 還設想在 2D/2.5D/3D 整合封裝晶片的內部,除了 CPU+GPU 混合計算核心,還集成更多模塊,包括 RAM、統一封裝光網絡通道物理層、特定域加速器等等,並引入高速標準化的晶片間接口通道(UCIe)。
另外,AMD 還設想在 2D/2.5D/3D 整合封裝晶片的內部,除了 CPU+GPU 混合計算核心,還集成更多模塊,包括 RAM、統一封裝光網絡通道物理層、特定域加速器等等,並引入高速標準化的晶片間接口通道(UCIe)。