 近期,Samsung 電子計劃將自主研發的 HPB(Heat Pass Block)封裝技術進行開放,首批合作的外部客戶包括高通與 Apple。
近期,Samsung 電子計劃將自主研發的 HPB(Heat Pass Block)封裝技術進行開放,首批合作的外部客戶包括高通與 Apple。
HPB 封裝技術是為高性能晶片進行散熱設計,可以直接將高效散熱器集成於晶片之上,高效提升熱管理效率。
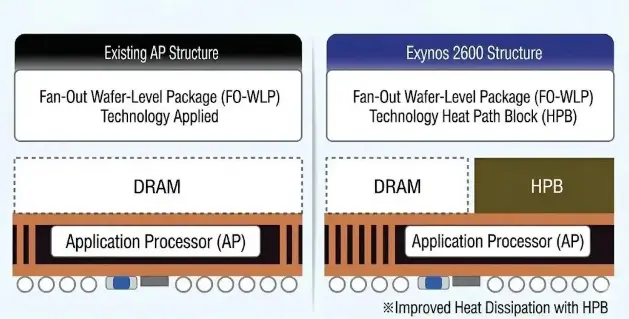 官方實測數據顯示,HPB 封裝技術可以讓晶片的平均運行溫度降低30%,從而讓晶片可以長時間的維持峰值性能頻率運行。
官方實測數據顯示,HPB 封裝技術可以讓晶片的平均運行溫度降低30%,從而讓晶片可以長時間的維持峰值性能頻率運行。
值得一提的是,Apple 從 2016年開始將 A10 處理器的代工訂單轉向台積電,高通從 2022年將 Snapdragon 8 Gen 1+ 訂單移交台積電,Samsung 的訂單量便快速下滑。為了吸引訂單,Samsung 試圖以 HPB 技術作為突破口。
Samsung 開放 HPB 封裝技術的方案,很可能會重塑晶片代工市場的競爭格局,突顯 Samsung 通過以尖端封裝技術奪回高級製程的計劃。










