據媒體報道,Samsung 封裝業務團隊正在開發一項名為 FOWPL-HPB 的封裝技術,預計將於今年四季度完成開發,做好量產準備。
 FOWPL-HPB 封裝技術的核心是一個名為 Heat Path Block(HPB)的散熱模塊,通過在處理器頂部增加一個熱路徑塊,從而顯著提高處理器的散熱能力。該技術已運用在服務器和PC的散熱技術中,現在有望首次應用於智能手機處理器上。
FOWPL-HPB 封裝技術的核心是一個名為 Heat Path Block(HPB)的散熱模塊,通過在處理器頂部增加一個熱路徑塊,從而顯著提高處理器的散熱能力。該技術已運用在服務器和PC的散熱技術中,現在有望首次應用於智能手機處理器上。
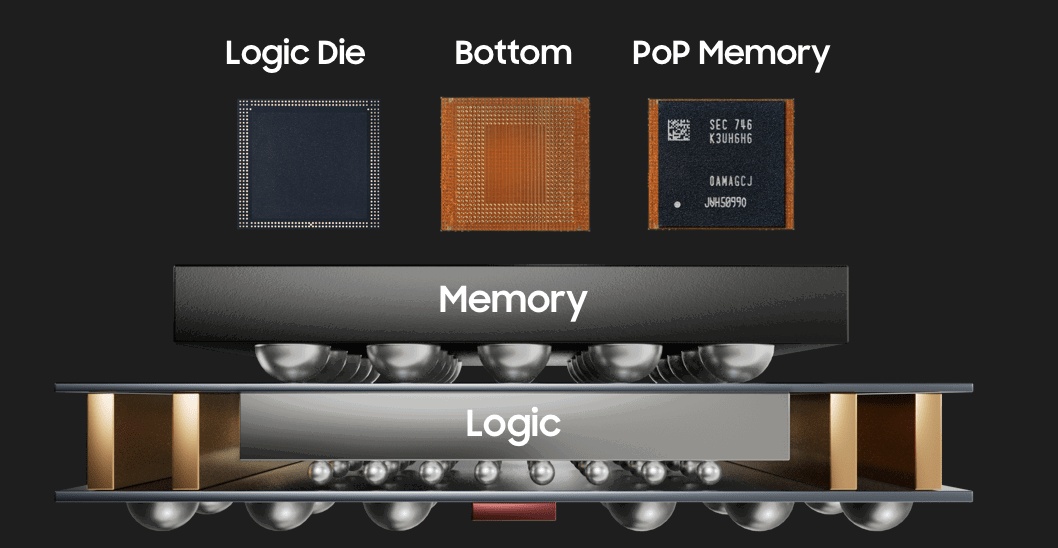 值得一提的是,Samsung Exynos 2400 採用的 FOWPL 扇出型晶圓級封裝技術實現了 23% 的散熱能力提升。如果下一代 Exynos 2500 處理器配備 FOWPL-HPB 技術,裝置性能將會有顯著的提升。
值得一提的是,Samsung Exynos 2400 採用的 FOWPL 扇出型晶圓級封裝技術實現了 23% 的散熱能力提升。如果下一代 Exynos 2500 處理器配備 FOWPL-HPB 技術,裝置性能將會有顯著的提升。
因在端側生成式AI需求日益增長,裝置耗電量和發熱量顯著上升,Samsung 希望通過 FOWPL-HPB 封裝技術來解決裝置的過熱問題。
還有爆料顯示,Samsung 計劃於明年進一步開發基於 FOWPL-HPB 的技術,目標是在 2025年四季度推出支援多處理器和 HPB 新型 FOWLP-SiP 技術。










